ポイント
- シリコンフォトニクスプロセスに適したナノインプリント用の光硬化性樹脂を開発。
- UVナノインプリントを用いた大面積・高スループットのシリコンフォトニクスプロセスを確立。
- 電子線描画による光導波路と変わらない特性を持つシリコン導波路の作製に成功。
概要
東京科学大学(Science Tokyo)※ 工学院 電気電子系の雨宮智宏准教授、永松周学士課程学生、西山伸彦教授らは、東京応化工業株式会社の森莉紗子、藤井恭、浅井隆宏、塩田大らと共同で、UVナノインプリント(UV-NIL)を用いたシリコンフォトニクスプロセスを開発しました。
ナノインプリントリソグラフィ(NIL)は、半導体における次世代リソグラフィ技術の一つとして期待されています。特にUV-NILは実用的な量産技術として導入実績があります。
本研究では、シリコンフォトニクスプロセスに合わせたNIL用の光硬化性樹脂の開発を行いました。さらに、SmartNIL®技術[用語1]に基づいたロールオンプロセスの最適化を実施し、従来の90 nm CMOS プロセスライン[用語2]や電子線描画[用語3]を用いて作られた光導波路と同程度の性能を得ることに成功しました。
今回開発したシリコンフォトニクスプロセスでは、UV-NILの大面積転写性や高スループット性を大いに活かすことができ、かつコストの観点からも優位性があると考えられます。
本研究は、東京科学大学内に設立された東京応化工業未来創造協働研究拠点において行われたもので、開発したナノインプリント用の光硬化性樹脂およびプロセスレシピは外部提供が可能です。併せて、本研究成果は、2025年1月25~30日(現地時間)に米国サンフランシスコで開催される「SPIE Photonics West」にて報告されます。
- 2024年10月1日に東京医科歯科大学と東京工業大学が統合し、東京科学大学(Science Tokyo)となりました。
背景
ナノインプリントリソグラフィ(NIL)は、ナノスケールのスタンプを用いた押印技術であり、従来の露光法と違って露光波長に解像度が依存しないことや、大面積転写性や高スループット性などを有していることから、半導体における次世代リソグラフィ技術の一つとして期待されています。特にソフトUV-NIL[用語4]は、半導体製造環境との互換性を担保しつつ、半永久的な機能層を大面積かつ高解像度でパターニングできることから、近年、拡張現実(ARグラス)や生物医学診断(DNAシーケンサー)などの新たなアプリケーションに対する実用的な量産技術として導入実績があります。さらに基礎研究レベルでも、メタマテリアルやメタサーフェスなどのウェハ光学素子を実現する際に活用されています。
そのような中で、半導体の製造技術を用いてウェハ上に大規模な光回路を構築する集積フォトニクス分野でも、NILを導入できる可能性があります。集積フォトニクス分野において特に高い解像度が必要とされる場面は、DFB(分布帰還型)レーザー[用語5]における回折格子の形成、光回路の入出力に使用するグレーティングカプラ[用語6]の形成、シリコンフォトニクス光回路における導波路の形成などであり、いずれも100 nm程度の解像度が保証されていれば十分といえます(図1の赤帯域)。そのため、上記プロセス工程では、NILの大面積転写性や高スループット性を大いに活かすことができ、かつコストの観点からも優位性があると考えられます。
本研究ではこうした背景から、集積フォトニクスの一分野として近年発展が著しいシリコンフォトニクスに着目して、実際にUV-NILを導入したプロセスを開発しました。
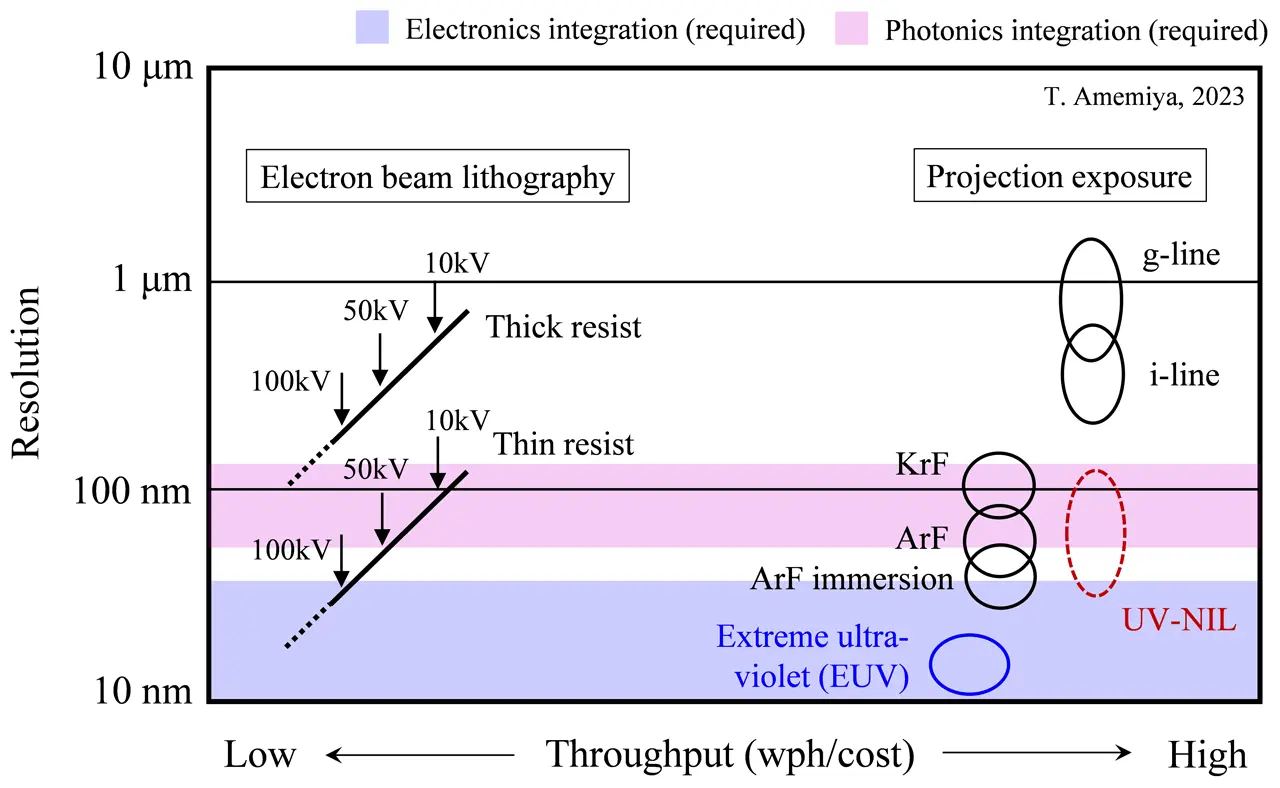
研究成果
本研究では、東京科学大学内に設立した東京応化工業未来創造協働研究拠点において、シリコンフォトニクスプロセスに合わせたNIL用の光硬化性樹脂の開発を行うとともに、SmartNIL®技術に基づいたロールオンプロセスの最適化を行いました。これにより、開発したプロセスを用いて作製したシリコン導波路では、従来の90 nm CMOS プロセスラインや電子線描画を用いて作られた光導波路と同程度の性能を得ることに成功しました。
成果1:光硬化性樹脂の開発
今回開発した、シリコンフォトニクスプロセスに適した光硬化性樹脂(図2)は、UV-NILの標準仕様[用語7]に加えて、シリコンフォトニクスプロセスに必須となる以下3つの特徴を有しています。
(1)SF6-C4F8混合ガスによるエッチング耐性
標準的なシリコンフォトニクスプロセスでは、シリコン導波路構造を形成するために、SF6-C4F8混合ガスによる擬似的なボッシュプロセスを用いて、膜厚200-300 nmのシリコン層を削りきります。そのため、このプロセスで用いる光硬化性樹脂には、SF6プラズマに対する高いエッチング耐性が要求されます。併せて、SF6-C4F8混合ガスによる変質性も極力抑えることが求められます。
(2)O2アッシングによる除去性
一般的なUV-NILで用いられる光硬化性樹脂は、主にフッ酸溶液処理により除去できるようデザインされています。しかしシリコンフォトニクスでは、下部クラッド材としてSiO2を用いていることから、エッチング後の除去プロセスとしてフッ酸溶液処理は適当ではありません。そのため、有機溶剤処理もしくはO2プラズマアッシングで除去できることが必須となります。
(3)ワーキングスタンプ剤との親和性
光硬化性樹脂には、スタンプモールド表面からの適切な離型が可能なデザインが必須となります。併せて、NILプロセス時に均一にUV照射を行う目的から、光硬化性樹脂の屈折率はスタンプモールドの屈折率と近いことが望ましいです。今回は、EVGのナノインプリント装置をベースとしており、スタンプ剤としてEVG NIL UV/AS5を用いています。

成果2:UV-NILを用いたシリコンフォトニクスプロセスの確立
今回開発したシリコンフォトニクスプロセスは「NIL工程」(図3a)と「光回路形成工程」(図3b)の2つのプロセスフローに分かれています。
NIL工程
- 工程A:
- 光回路パターンが形成されたシリコンマスタースタンプに、離型剤およびワーキングスタンプ剤(EVG NIL UV/AS5)を塗布(図3aの1, 2)
- 工程B:
- 上部からポリエチレンテレフタラートのフレキシブルバックプレーンを押し当てて、紫外線硬化させた後に離型(図3aの3, 4)
- 工程C:
- SOI(Silicon on Insulator)ウェハに密着材および開発した光硬化性樹脂をスピンコートした後、先ほど作製したワーキングスタンプを押印(図3aの5, 6)
- 工程D:
- UV照射を行った後、ワーキングスタンプを脱離させ、NILによって光回路パターンを形成(図3aの7, 8)
本プロセスでは、光硬化性樹脂の膜厚および充填率、回路レイアウトなどを最適化することで、膜厚20 nm以下の残膜制御が可能となっています(図4a)。
光回路形成工程
- 工程A:
- SF6-C4F8混合ガスによるドライエッチングにより光硬化性樹脂の残膜除去(図3bの1)
- 工程B:
- 連続してSF6-C4F8混合ガスによるドライエッチングにより、シリコン層をエッチング(図3bの2)
- 工程C:
- O2アッシング処理により、マスクとして用いた光硬化性樹脂を除去(図3bの3)
- 工程D:
- プラズマCVDにより、上部クラッドとしてSiO2を堆積(図3bの4)
NILによるパターン形成後は、光硬化性樹脂の除去にO2プラズマアッシングを用いる点を除いて、標準的なシリコンフォトニクスプロセスと同一の手順です。エッチング工程では、十分な垂直性を維持したまま、標準的なシリコン導波路パターンを形成できることを確認しました(図4b)。
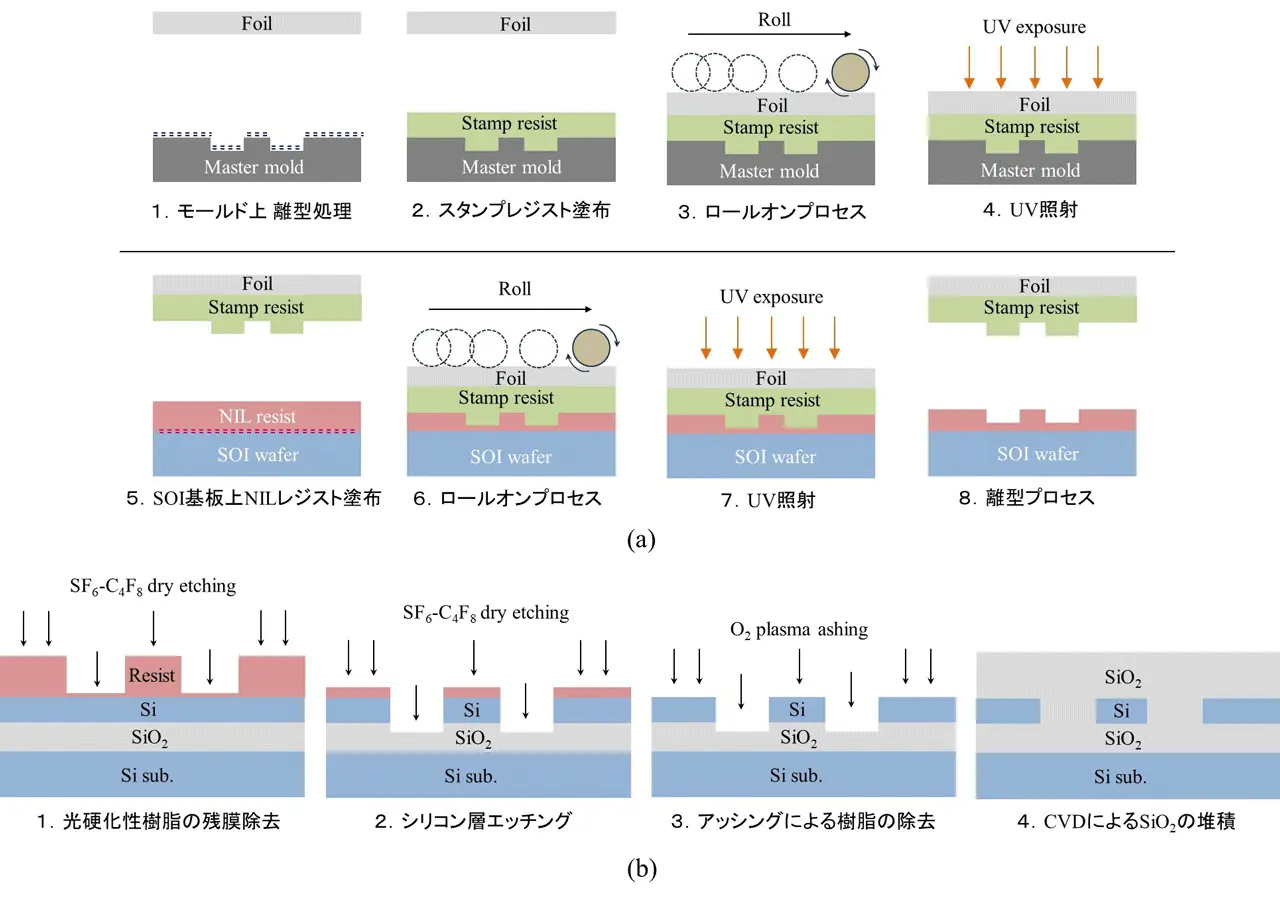
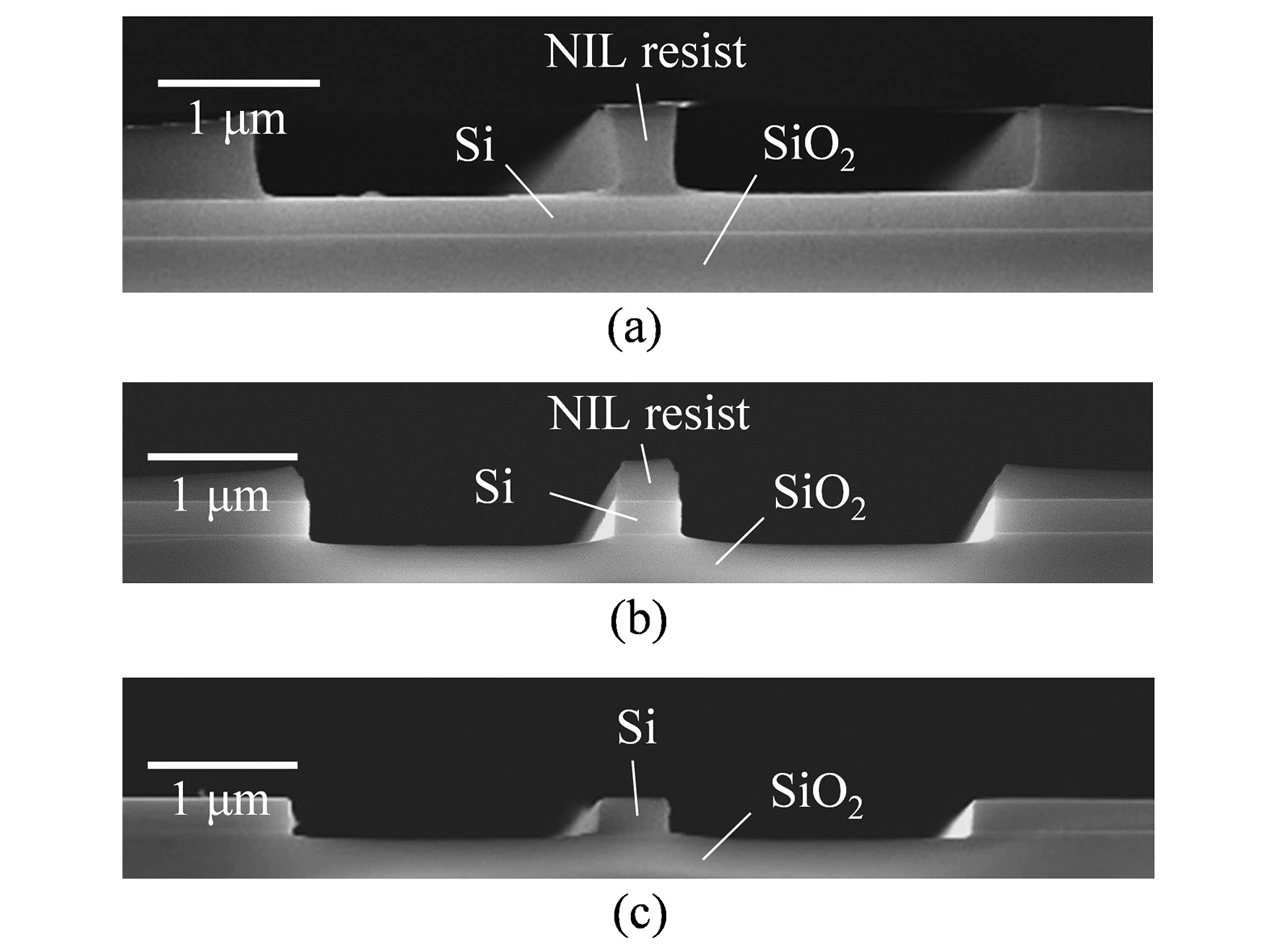
成果3:開発プロセスで作製したシリコン導波路の伝搬特性
今回開発したプロセスで作製したシリコン導波路の伝搬特性を評価した結果、波長1,550 nmのTEモード光に対する単位長さ当たりの伝搬損失は1.6 dB/cm程度となりました(図5)。これは、従来のドライArFが用いられる90 nm CMOS 試作ラインや電子線描画を用いて作られたシリコン導波路と遜色ない値であり、NILによって十分な性能を持つ光回路が形成可能であることを示しています。

社会的インパクト
シリコンフォトニクスは、高速、高帯域、低エネルギーであることから、将来のデータセンターとデータ伝送のボトルネックを解決するための重要な技術の一つと見なされています。本技術は、シリコンフォトニクス関連のデバイス開発と産業応用を推進する上での一助となり、光電融合も見据えたシリコンフォトニクス分野拡大に貢献できると考えられます。東京科学大学内に設立した東京応化工業未来創造協働研究拠点において、本学のミッションである「科学の進歩」と「人々の幸せ」とを探求し、社会とともに新たな価値を創造し続けます。
今後の展開
EUVなどの超高解像露光技術を必要とする先端電子デバイス・集積回路分野と比較すると、フォトニクス分野では露光プロセスにそれほど高い解像度を必要としないため、NILの大面積転写性や高スループット性を大いに活かすことができます。将来的には、シリコンフォトニクスを扱っている各ファウンドリの標準プロセスラインへのNIL導入も期待されます。また、従来の露光法では難しい3次元露光も可能であり、それを積極的に利用した新たな光デバイスの実現も示唆されます。
付記
本研究は、以下の援助によって実施されました。
-
東京応化工業未来創造協働研究拠点
研究課題:「半導体製造工程に用いる材料や化学薬品、加工技術を基軸とした、フォトニクスデバイスやライフサイエンス、カーボンニュートラルに関する研究」
拠点長:西山伸彦 東京科学大学 教授
副拠点長:鳴海裕介 東京応化工業 新事業開発本部 本部長
-
東京工業大学「東工大の星」特別賞(STAR)
研究代表者:雨宮智宏 東京科学大学 准教授
用語説明
- [用語1]
- SmartNIL®技術:透明なフレキシブルポリマーのワーキングスタンプを使用して、ウェハレベルでUVナノインプリントを行う技術。半導体装置メーカーであるEV Group社が開発した。
- [用語2]
- CMOS プロセスライン:シリコンLSIの試作ラインを使って光集積回路を作る技術。KrFエキシマレーザー光(波長248 nm)、ArFエキシマレーザー光(波長193 nm)を用いた露光を基本とする。90 nmラインでは、ArFを導波路作製に主に用いられる。
- [用語3]
- 電子線描画:電子線に感光する樹脂薄膜に微細パターンを描画する技術。主に、基板に直接描画することによる少量多品種の試作品の開発や、半導体チップのレチクルの作製に用いられる。
- [用語4]
- ソフトUV-NIL:ポリマーで形成された柔軟な透明スタンプを使用してナノインプリントを行う技術。
- [用語5]
- DFB(分布帰還型)レーザー:半導体レーザーの一種で、レーザー中に設けた周期的構造によって不要な波長の発振を抑圧し、単一波長の光出力を実現する。通信用の半導体レーザーの多くに用いられる。
- [用語6]
- グレーティングカプラ:光ファイバとシリコン基板上のSOI導波路を効率的に結合するためのデバイス。基板導波路に回折格子状の適切な周期構造を与えることによって、光ファイバから入射した光を基導波路板内に回折させ、光を結合する。
- [用語7]
- UV-NILの標準仕様:反応性イオンエッチング耐性を付与するためにシロンキサンを含有した重合性モノマー、硬化樹脂の力学強度や熱耐性を付与する架橋剤分子、光重合開始剤、基板への密着を促進する添加剤やモールド表面からの離型を促進する添加剤などを含んでいる。
技術資料・技術提供
-
開発したナノインプリント用の光硬化性樹脂
東京応化工業株式会社からサンプル品として外部に提供可能 -
開発したシリコンフォトニクスのプロセスレシピ
東京科学大学からデータシートとして外部に提供可能
外部発表
“Development of silicon photonics process using UV nanoimprinting”
SPIE Photonics West 2025, Silicon Photonics XX 13371-42 (2025).
研究者プロフィール
雨宮 智宏 Tomohiro AMEMIYA
東京科学大学 工学院電気電子系 准教授
研究分野:フォトニクス
森 莉紗子 Risako MORI
東京応化工業株式会社
研究分野:高分子化学
関連リンク
お問い合わせ
取材申込み
東京応化工業株式会社 広報IR部
- ir@tok.co.jp
- Tel
- 044-435-3000
東京科学大学 総務企画部 広報課
- media@adm.isct.ac.jp
- Tel
- 03-5734-2975
- FAX
- 03-5734-3661